193nm波长光刻机粗认识
讨论课题目:193 nm 波长的光刻机能刻出最窄线宽多少的芯片?重点研究工作波长 193 nm 的投影光刻物镜,阐述其中的光学原理,画出结构原理图,探讨波长、数值孔径和分辨率等光学系统参数的选择问题,分析主要像差
在开始前首先提两个名词:
EUV:极紫外光刻(Extreme ultra-violet),第五代光刻机(目前最先进)采用波长为13.5nm的极紫外光作为曝光光源, 分辨率可达ArF光刻机 3~5倍;Nikon 公司把EUV 之前的投影物镜设计分为四代。
DUV:深紫外光刻(Deep Ultraviolet Lithography),第四代光刻机采用了193nm的 ArF(氟化氩)准分子激光,有浸没式光刻和双重光刻工艺;
浸入技术:让镜头和硅片之间的空间浸泡于液体之中,采用纯净水且折射率为1.44,193nm的ArF光经过纯净水的折射后,等效波长为134nm,从而实现更高的分辨率
Q1最窄线宽
193 nm 波长的光刻机能刻出最窄线宽多少的芯片?
理论上,使用193纳米浸入式ArF光源的DUV光刻机一次曝光可以生产的最小极限尺寸就是28纳米,通过多次曝光(最少是4次)如今可以做到7nm的芯片。
EUV可以做到一次获得7nm的芯片,DUV多次曝光每次的成本都相当昂贵。从效率和成本上来说,这也是现如今仍然需要EUV的原因(这一技术现在仅ASML公司拥有)
Q2投影光刻物镜的光学原理
工作波长 193 nm 的投影光刻物镜的光学原理
先放一张投影光刻机的简易原理图:(网图)
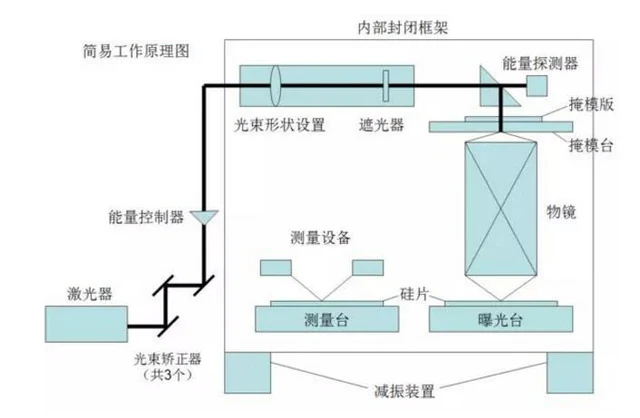
物镜的主要作用是把掩膜版上的电路图按比例缩小,再被激光映射的硅片上,并且物镜还要补偿各种光学误差。技术难度就在于物镜的设计难度大,精度的要求高。
投影光刻物镜采用的准分子激光光源具有很强的时间相干性,但光源在空间上具有扩展性,即照明光源的“有效光源”是一个面光源,此时掩膜上的照明光是来自多个方向的平面波的叠加,这种照明方式成为部分相干照明。图中照明出瞳表示
照明系统,物镜光瞳、入瞳和出瞳表示投影光刻物镜

有效光源上每个光源点都对应一束以一定角度入射到掩膜面上的平面波,不同的光源点对应平面波的角度不同,在掩膜处形成近场衍射分布,各级衍射光经过入瞳面到达出瞳面时,其振幅、相位和偏振态受到物镜影响而发生变化,导致出瞳面处各级衍射光的传播方向发生改变,出射的各衍射级次光波在像面上相干叠加,得到该光源的相干成像
物镜结构
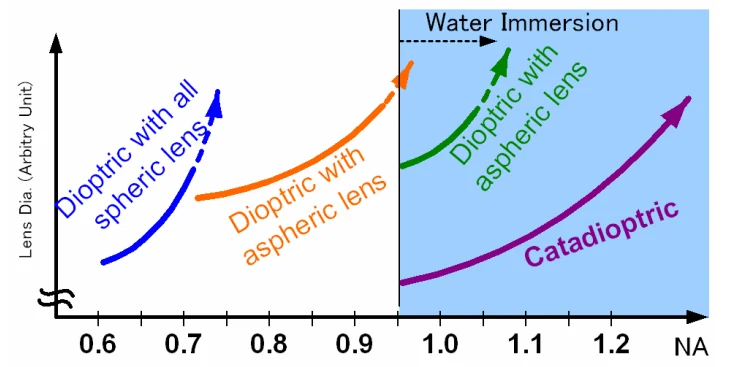
球面:
随着 NA 的增加,场曲的校正更加的困难,E. Glatzel 提出了一种“腰肚”结构的方法来减小场曲,系统的结构依次为正组,负组,正组,负组,正组,这时镜头的特点是边缘光线的轨迹形成了 2 个“腰”,所以该种系统结构通常称为“双腰”,这种结构自 1987 年后就一直采用至今。

非球面:
当数值孔径超过 0.7 时,系统元件口径会急速增大,非球面元件不仅能够补偿每组各自的像差,同时也能补偿其他元件组产生的高级像差,在非球面设计方案中,一些像差(甚至是一些低阶像差)残留在各表面上,然后通过使用数个非球面元件来补偿这些残存的像差,随着非球面元件数目增加,双腰结构逐渐演化为单腰结构。
折返式结构:
在折射式光刻物镜为了校正匹兹万场曲,必须使用大光焦度的负透镜和大口径的正透镜,产生的副作用是三叶像差占主导,因此发展出了折返式投影光刻物镜。折返结构中凹面反射镜产生的副作用非常小,因为反射镜具有正的光焦度和负的场曲,因此就不需要大光焦度的负透镜和大口径的正透镜来满足场曲的控制
现在市场上193nm光刻机主要为浸入步进式投影光刻机(步进式指可以连续曝光),主流的浸没式投影物镜均采用折反式结构,NA达到惊人的1.35,而水的折射率是1.44左右,这基本上是当前浸液条件下的极限。如果想进一步提高NA,只能研究新的光学材料和浸没液体,但进展有限
折返式设计有同轴两反射镜系统和离轴三反射镜系统两种(以下简称同轴式和离轴式,也可叫单轴或多轴)
同轴折返式光刻物镜该结构主要包括折射镜组、反射镜组和数值孔径组(即折射物镜组2)
折射镜组和反射镜组的主要功能是平衡系统像差,数值孔径组将中间像传承到像面上并保证较大的数值孔径和较小的远心度。其中反射镜组由2个反射镜组成,且光轴与折射镜组相同。反射镜组之间的成像光束近似平行,使反射镜组两端的两个中间像比例接近1∶1,有助于校正像差。
远心度:横向位置偏移=d变化× tanθ,远心度越小,对准精度越高
 离轴折返式光刻物镜
离轴折返式光刻物镜
该结构包含3个反射镜,其中2个是平面反射镜,1个是凹面反射镜
反射镜组的光轴与折射镜组的光轴垂直。系统内部包含2个中间像。该结构的最大特点是使用了Schumann中继结构,即在光瞳附近用了一片凹面反射镜和一个负透镜组。该子系统的放大率接近1,并且接近光瞳,所以不会附加非对称性像差。负透镜组与凹面反射镜组合使用可以很大程度上矫正场曲,并在一定程度上降低色差。选择曲率适当的反射镜和凹透镜组有利于降低中间像的像差,进而降低整个光刻物镜的像差 。

总的来说同轴方案的NA值大于离轴方案,但代价就是元件的加工难度更高,离轴方案的机械结构更复杂。同轴方案具有唯一的光轴,结构较为紧凑,离轴方案具有水平和垂直两个光轴,对机械设计和装调提出了更多挑战,而且由于反射镜位于光瞳附近,这意味着较小的反射镜倾斜就会引起较大的像面倾斜。综上所述,无论是机械结构的复杂度还是装配技术的难度,离轴方案都要比同轴方案高得多,离轴方案的另一个缺点是它对折射式光刻物镜所用的掩模板没有继承性。
Q3光学系统参数的选择
探讨波长、数值孔径和分辨率等光学系统参数的选择问题
光刻机的分辨率公式:$\mathrm{R}=kλ/\mathrm{NA}$,$k$为工艺因子或制程因子(分辨率也可用CD表示)
像素数的计算公式$N\approx A^2/CD^2$ ,$A$指硅片面曝光视场的大小
波长
常见光源分为:
可见光:g线(436nm)(一代)
紫外光(UV):i线(365nm)(二代)
深紫外光(DUV):KrF 准分子激光(248 nm)(三代),ArF 准分子激光(193 nm)(四代)
极紫外光(EUV):13.5nm(五代)
由分辨率公式可知波长$\lambda$越短,数值孔径NA越大,分辨率越高;但波长越短制造的难度也随之上升,主流EUV光源为激光等离子光源(LPP),目前只有美国厂商Cymer和日本厂商Gigaphoton才能够生产,EUV极紫外光刻机唯一可使用的镜头由卡尔蔡司生产,ASML垄断了全球高端光刻机的供应
为何直接193nm没有再减小呢?
当光源波长发展到F2准分子激光器157纳米激光,由于光刻胶和掩膜材料的局限,图形对比度低等因素,使得157纳米光刻技术的发展受到很大限制,又由于193纳米光源等效波长小于157纳米,同时投影透镜数值孔径也有很大的提高,所以采用浸没技术的193纳米光源取代157纳米光源继续成为研究的热点。
数值孔径
在使用的光源波长一定的情况下,物镜的数值孔径NA决定实际的分辨率,是衡量光刻物镜性能的重要指标
非球面的应用使物镜NA可以增加到0.92接近物理极限(干式光刻)
引入浸没式技术后,物镜NA可以增加到1.1以上(浸没式光刻)
加入反射镜组成折反式结构理论上物镜NA可到1.35(极限值)
(干式)球面镜→非球面镜→(浸没式)非球面镜→折返式
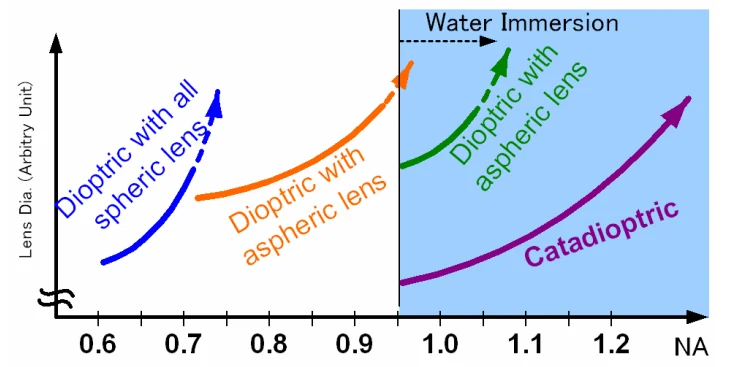
光刻机投影物镜发展

Q4像差
分析主要像差
常见像差:慧差,像散,场曲,畸变,色差
常见像差的消除主要是在物镜结构上
主要像差有热像差,波像差,偏振像差
波像差
投影物镜的波像差在过去已经得到了显著降低,20世纪八十年代投影物镜的波像差RMS值只有λ/20,现在最新的浸没投影光刻物镜,波像差RMS值已经降低到了λ/400,也就是0.5nm左右,这里就不再叙述
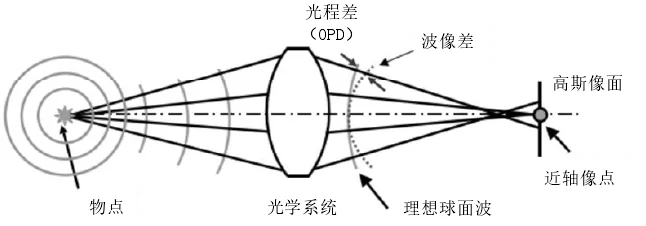
热像差
热像差的产生原理:
光刻机工作时激光持续照射投影物镜,热量在投影物镜内部大量累积,镜片局部温度明显变化,导致镜片材料折射率和面形随之发生变化,进而增大投影物镜的像差,由投影物镜热效应导致的像差称为热像差,是影响光刻机成像质量的主要因素之一。
产生的热像差主要通过光学轴向移动、力变形镜技术、温控变形镜等技术进行补偿。
中科院上海光学精密机械研究所对光刻机投影物镜热效应模型及热像差预测技术进行了研究,在热效应快速仿真模型、热效应严格模型,以及基于热效应经验模型的热像差在线预测技术方面取得进展,建立了一种投影物镜热效应快速仿真模型热像差仿真精度(Rs2)优于0.99。
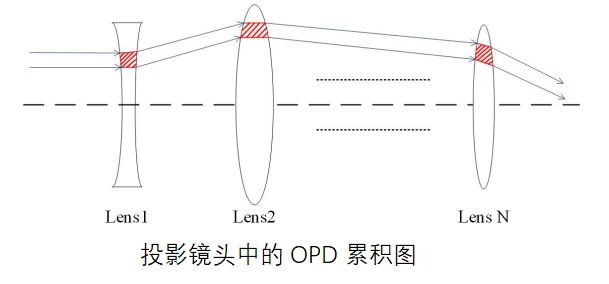
偏振像差
偏振像差的定义:
随着投影物镜NA的不断增大,照明光的偏振态对物镜成像的影响不能忽略,需要用偏振照明技术来提高分辨率。但照明系统不能生成理想的偏振照明模式,且光线在经过投影物镜后,由于膜系的影响,材料双折射的影响、表面散射的影响等因素,会使入射光线的偏振态会发生改变,这种偏振态的改变就是偏振像差。
偏振像差的对光线偏振态的改变主要有两类效应:延迟和衰减
材料双折射:
大部分材料因在深紫外波段吸收率太大而无法使用,在深紫外波段,结晶材料 CaF2 以其足够良好的透射性和低应力双折射而成为投影光刻物镜的镜片制造材料。CaF2 的固有晶体结构导致了它的本征双折射,双折射最直接的影响就是光传播时两个正交偏振态之间会有光程差,即位相改变不同,产生延迟。
修正方法:
组合法:将不同晶向特定方位角的 CaF2 镜片组合,利用各个组合 CaF2 镜片互相补偿部分双折射的方法
组合方位角 0°和方位角45°的 CaF2 镜片,得到近似切向圆分布的延迟
组合方位角 0°和方位角 60°的 CaF2镜片,得到近似径向圆分布的延迟

缺点:当系统 CaF2 镜片较少时,或系统要求晶向单一时,补偿效果会受到限制。其次,组合法所选的方位角是一些特定值如 45°、60°,对于一个复杂的系统来说,这些角度的补偿效果很可能不是最优。
旋转法:原理是最优化算法,找到每个CaF2最佳的旋转角度,获得最小的延迟
参考文献:
[1]张德福,李显凌,芮大为,李朋志,东立剑,张建国.193nm投影光刻物镜光机系统关键技术研究进展[J].中国科学:技术科学,2017,47(06):565-581
[2]徐明飞. 高数值孔径投影光刻物镜的光学设计[D].中国科学院研究生院(长春光学精密机械与物理研究所),2015.
[3]尚红波. 浸没光刻投影物镜光学设计与像差补偿研究[D].中国科学院大学(中国科学院长春光学精密机械与物理研究所),2021.DOI:10.27522/d.cnki.gkcgs.2021.000007.
[4]周泽龙. 投影光刻物镜偏振像差研究[D]. 中国科学院大学 (中国科学院长春光学精密机械与物理研究所), 2018.
[5]Zhu B, Li S, Mao Y, et al. Fast thermal aberration model for lithographic projection lenses[J]. Optics Express, 2019, 27(23): 34038-34049.






